AI普及帶動超大規模資料中心(AI Data Center, AI-DC)中,新型光通訊領域的快速成長。在此趨勢下,「玻璃基板」作為先進封裝的關鍵材料,又重新回到產業焦點,成為半導體與系統整合技術的重要發展方向。
AI與CPO推動玻璃基板再度崛起
近年來,隨著共同封裝光學(CPO, Co-Packaged Optics)技術成熟,資料傳輸逐步從純電訊號轉向電光整合架構。玻璃基板因具備低訊號損耗、高平坦度與優異熱穩定性,被視為支撐高速光電整合的理想材料。這也促使市場重新啟動,甚至加速玻璃基板的開發計畫。
在全球競爭格局中,各大科技企業正搶占玻璃基板商業化前的重要位置。包括韓國企業如SK海力士(SK hynix)、LG、三星等公司,均積極加速與材料、製程供應商達成合作。SK甚至於美國布局產線,專注於中介層(interposer)技術開發,顯示其搶攻量產前主導地位的意圖。
目前業界關注的一大焦點在於,究竟是「玻璃核心基板」還是「玻璃中介層」會率先進入量產?
玻璃核心基板(Glass Core Substrate):作為整體封裝的基礎結構,具備高剛性與低熱膨脹特性,有利於大尺寸封裝與高密度整合。
玻璃中介層(Glass Interposer):主要用於晶片間高速訊號傳輸,相較於傳統有機材料,不僅成本潛力較低,且在訊號完整性與頻寬表現上更具優勢。
整體而言,兩條技術路線仍在並行發展,但皆與AI晶片封裝需求高度相關。
美韓日大廠加速布局
2026年初舉辦的日本國際電子製造關連展(NEPCON JAPAN),也看出國際大廠對於玻璃基板的商業布局。
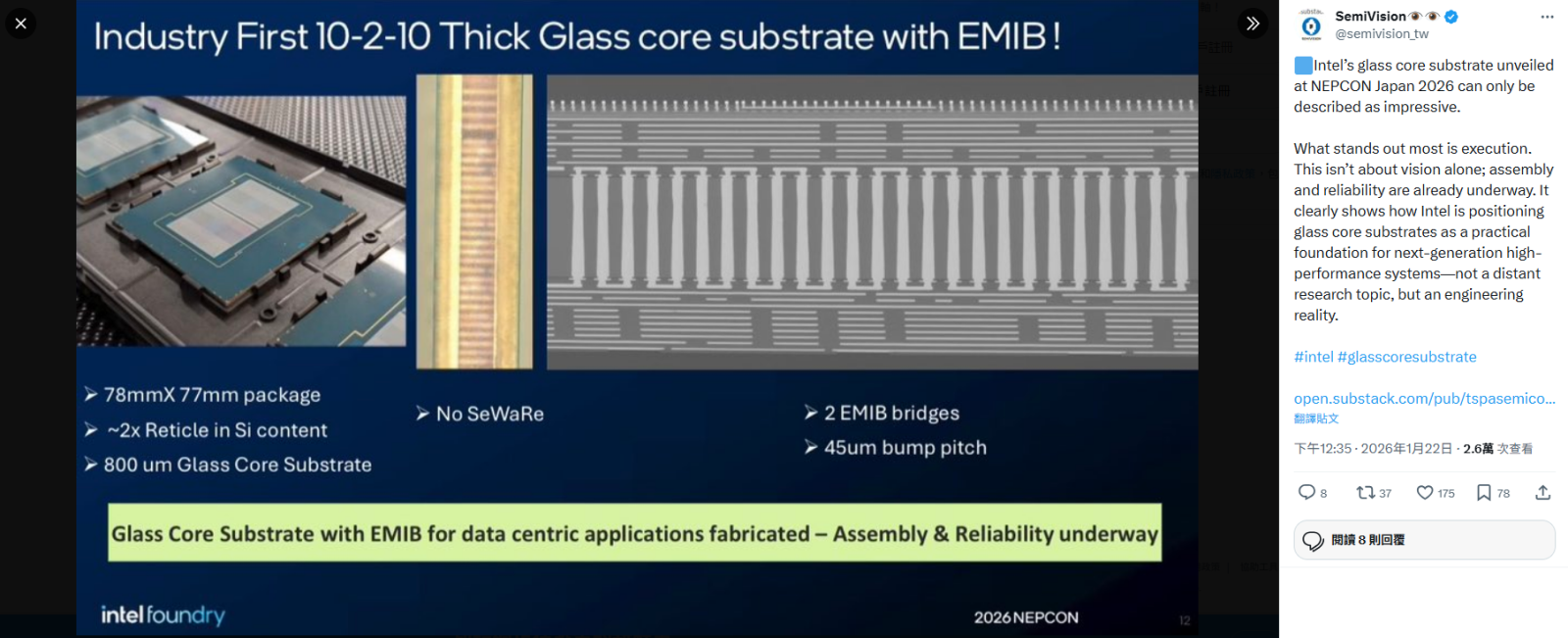 圖:翻攝自@semivision_tw
圖:翻攝自@semivision_tw
Intel早在多年以前即投入玻璃基板技術開發,在NEPCON Japan 2026上,展示了一款與其嵌入式多晶片互連橋(Embedded Multi-die Interconnect Bridge, EMIB)封裝技術整合的「厚芯」玻璃基板,顯示其在相關領域的持續推進。
在技術展示上,可見銅電配線(Electrical Routing)與光導波路(Optical Waveguide)兩者共存於同一基板之上,形成電光整合架構。此外,相關展示亦呈現多層光導波路設計,可在玻璃基板內不同水平層中構建光路,使光訊號能在三維空間中進行傳輸,提升互連密度與效率。
業界普遍預期,未來將朝向光導波路完全嵌入玻璃基板中,形成高度整合的光電共封裝架構。
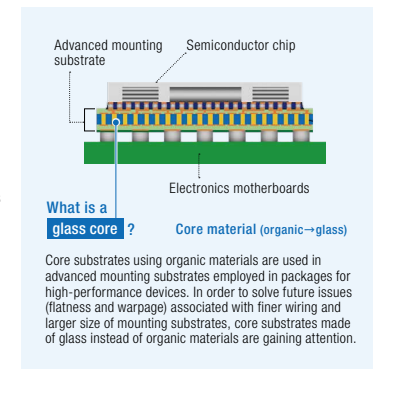
圖:翻攝自DNP Integrated Report 2025
日本企業方面也動作頻頻,例如大日本印刷株式會社(DNP)投入光導波路在玻璃基板中的內嵌技術開發。其技術方向包括將光導波路嵌入玻璃基板內部、在基板上整合GPU與高頻記憶體(HBM),並透過內部光路實現晶片間高速光訊號傳輸。
隨著全球企業加速投入,玻璃基板的量產時程與技術成熟度,將影響下一世代半導體競爭格局。
首圖:Intel官方提供